摘要:
金丝具有优良的导电性、导热性、耐腐蚀性和耐氧化性,在微电子封装中常常使用金丝作为引线键合的主要材料。然而,对于PCB 来讲,并非所有的表面处理工艺都适用于金丝引线键合,不同 的表面处理在金丝键合的过程中有不同的特点。本文着重于对化学镍钯金(ENEPIG)的金线键合过程进行探讨,通过一系列试验对化学镍钯金各镀层在金线键合过程中的作用进行研究,总结出化学镍钯金的金线键合机理。
关键词:
金丝 引线键合 化学镍钯金 键合机理
一、前言
由于IC晶片的广泛使用,电子产品不断向轻薄、短小、高速等特性发展,电子产品的封装技术也在不断发展,其中COB已成为一种普遍的封裝技术。
COB(Chip On Board)技术是指将裸芯片直接贴在PCB板上,然后使用金属线进行电子连接的技术,即Wire Bonding。由于金丝具有优良的导电性、导热性、耐腐蚀性和耐氧化性,在微电子封装中常常使用金丝作为引线键合的主要材料。

对于PCB来讲,目前用于金线邦定的表面处理主要有电镀镍金和化学镍钯金两种,电镀镍金金层较厚,成本较高,且对表面贴装可焊性具有一定的影响。镍钯金技术在20世纪80年代已经开始应用[1],但是在国内目前应用仍然比较少。由于镍钯金能够同时满足邦定和焊接的需求,必然会得到越来越广泛的应用。而目前对于镍钯金邦定的机理认识较少,对于失效分析以及过程控制的依据认识不足。因此,本文着重于对化学镍钯金(ENEPIG)的金线键合过程进行分析,通过实验研究化学镍钯金的镀层在金线键合过程中的作用,探讨了化学镍钯金的金线键合机理。
二、金线键合过程与化学镍钯金简介
2.1 金线键合过程
金线与焊盘键合一般使用热超声键合工艺,其工艺原理是在外加压力及超声频率振动的作用下,去除金属表面氧化膜,金线与焊盘表面接触形成微观焊点,随着焊点面积逐渐增大,界面间的微小孔洞消失,同时在高温作用下金属原子发生相互扩散,形成可靠的宏观焊点。[2]

通过金线邦定的过程可以看到,影响金线键合的主要因素有邦定参数,焊盘粗糙度,接触面积,镀层质量,表面氧化物及污染物等。要实现金线与焊盘的键合,去除金属表面的污染物、氧化物是非常重要的。当相互键合的金属表面存在污染物或者氧化物的时候,外加压力以及超声频率振动不能将氧化物或者污染物完全去除,就会对金线与焊盘的粘结产生不良的影响。
2.2 化学镍钯金(ENEPIG)
化学镍钯金的加工流程与沉镍金(ENIG)流程相似,只是在化学镍和化学金的中间加上一个钯缸,使镍层与金层之间增加了一层钯金属。其基本加工流程如下:除油→微蚀→酸洗→预浸→活化→后浸→化学镍(还原)→化学钯(还原)→化学金(置换)。[3]
通过扫描电镜观察镍钯金金层平整,厚度均匀,晶胞排列致密,具有良好的晶格结构;钯层晶格结构良好,剥金后观察晶胞结构致密,无细微裂缝。大量文献表明,在一定的镀层厚度条件下,镍钯金表面处理的焊盘具有良好的焊接性能和金线邦定性能。
三、镍钯金镀层对邦定的影响
3.1 钯层在金线键合过程中的作用
钯是一种常温下比较稳定的金属,400℃以内很难被氧化,化学沉积的钯层晶格排列整齐,晶粒大小均匀,结构致密,将钯层加在镍层和金层的中间,能够有效阻挡镍层向金层扩散。在PCB客户端焊接的过程中,一般都是先进行元器件的表面贴装,经过回流焊接后再进行金线邦定,而回流焊的高温过程加速了镍向金层的扩散速度,导致金层镍含量增加,镍氧化物增加而影响邦定结果。图4为沉金板(ENIG)与镍钯金板(ENEPIG)回流老化前后的邦定性能对比。

可以看到,沉镍金在回流前具有较好的邦定性能,回流后邦定性能大幅度下降;而镍钯金在回流前后邦定性能并没有太大的变化。通过XPS定量元素扫描分析结果可以看到,沉金板回流后金层中镍含量大幅增大,而镍钯金的金层中镍含量并没有太大的变化,如表格1所示。
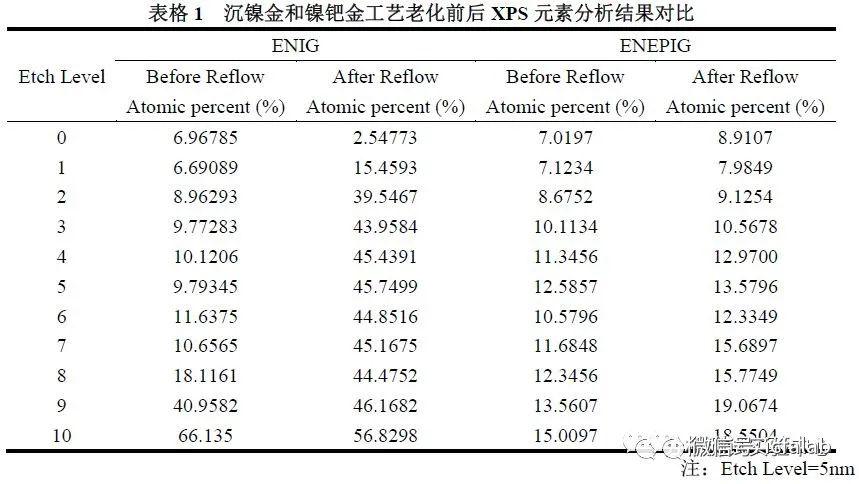
由此可见,沉金板不能用于邦定的主要原因是镍元素容易向金层迁移,由于镍元素极易氧化,迁移至金层后导致金层氧化物含量增多,邦定性能下降。而镍钯金由于钯层阻挡了镍元素向金层扩散,从而使得金层能够保持较好的洁净状态,回流前后邦定性能均没有太大的影响。下图是不同钯层厚度的镍钯金回流之后的邦定金线拉力趋势图,可以看到,随着钯层厚度的增加,金线拉力呈现上升的趋势,但是到达一定程度后这种趋势停止,表明到达一定厚度,钯层阻挡镍扩散的能力到达极限,邦定性能不再持续上升。

3.2 金层在金线键合过程中的作用
金层的主要作用是与金线进行键合,当镍层与金层之间没有钯层作为扩散阻挡层时,只要金层达到一定的厚度,回流后也具有金线邦定的能力,例如电镀镍金的金厚达到0.3um后就能够与金线进行键合。对不同金层厚度的电镀镍金老化后的邦定性能对比也证明了这一点,如下面的对比试验结果。
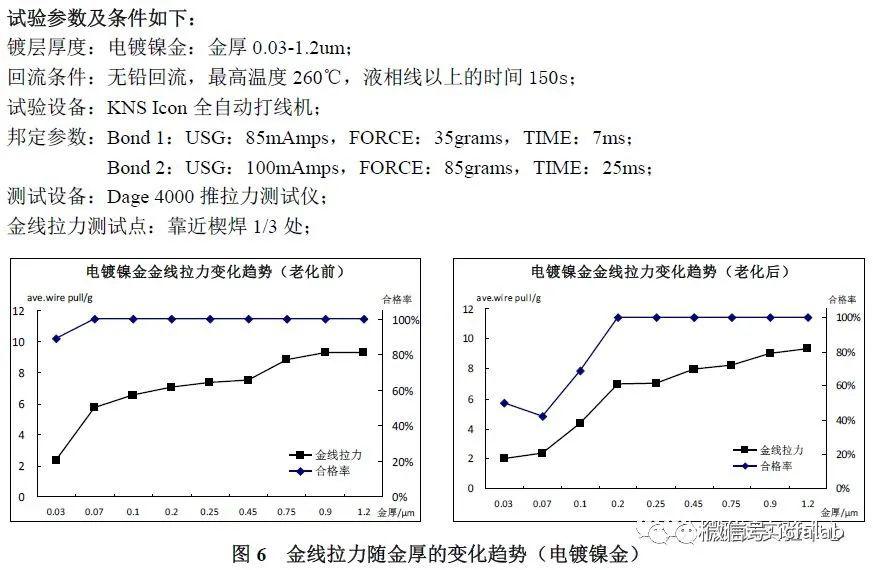
由上述的试验结果可以看到,电镀镍金回流前具有一定的邦定性能,当金层厚度不足时,回流后邦定性能下降。主要的原因是因为金层太薄的时候镍元素会扩散至金层,导致金层杂质含量增多,邦定性能下降。
金层本身具有良好的与金线邦定的能力,在化学镍钯金表面处理中,由于钯层保护了金层不被镍元素污染,因此只需要较薄的金层就具有良好的邦定性能。试验表明,在0.035-0.1um的金厚范围内,邦定后金线拉力并没有明显的变化,如图7为不同金层厚度的镍钯金邦定后金线拉力测试结果。

四、结论
金层的杂质和氧化物是影响金线与焊盘键合成功的主要影响因素之一,而一般的金线邦定是在表面贴装之后进行的,当没有钯层存在的时候,表面贴装过程的高温加快了镍元素向金层的扩散速度,导致金层被污染,从而影响金线与金层结合的能力。化学镍钯金能够用于邦定的主要原因得益于钯层对镍层的阻挡作用,当钯层存在时,不仅能够抑制表面处理加工过程中镍层的腐蚀氧化,而且在表面贴装过程中能够阻挡镍元素向金层扩散,使得较薄的金层就具有了良好的邦定性能,并且降低了金的成本。
参考文献:
[1]林金堵等.化学镀镍/化学镀钯/浸金表面涂覆层的再提出.印制电路信息,2011(3),29-32;
[2]宗飞等.电子封装中的固相焊接:引线键合.电子工业专用设备.2011,40(7);
[3]郑莎等. 化学镀镍镀钯浸金表面处理工艺概述及发展前景分析.印制电路信息.2013(5);
[4]林金堵,吴梅珠. 化学镍/化学钯/浸金的表面涂覆层的可焊性和可靠性.印制电路信息.2011(5).

分享二维码到朋友圈免费为您发文章一篇
欢迎各公众号,媒体转载
投稿/推广/合作/入群/赞助/转发 请加微信13488683602
