е°ҒиЈ…еҲҶеұӮ并й•ҝжңҹжҡҙйңІдәҺжҪ®ж№ҝзҺҜеўғ

еҷЁд»¶еҸ—зғӯпјҢе°ҒиЈ…еҶ…ж°ҙжұҪиҶЁиғҖпјӣ
жңәжў°еә”еҠӣеј•иө·иҠҜзүҮеҪўеҸҳе’ҢеҺӢз„ҠзӮ№и„ұиҗҪпјӣ
жјҸз”өжөҒеҸҳеҢ–жҲ–ејҖи·ҜгҖӮ
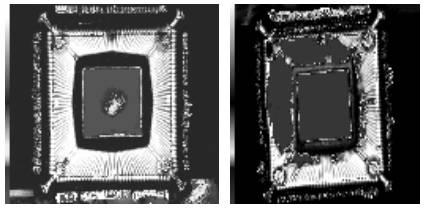
дҫӢпјҡзҲҶзұіиҠұж•Ҳеә”еј•иө·еЎ‘е°ҒеҷЁд»¶еҶ…еј•зәҝејҖи·Ҝ
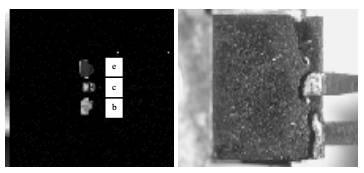
дҫӢпјҡеҢ…е°Ғж–ҷпјҚй”®еҗҲзӮ№еҲҶеұӮеј•иө·еЎ‘е°ҒеҷЁд»¶еҶ…еј•зәҝејҖи·Ҝ
зә жӯЈжҺӘж–Ҫ
иЈ…й…ҚеүҚеЎ‘е°ҒеҷЁд»¶дёҚиғҪй•ҝж—¶жҡҙйңІдәҺжҪ®ж№ҝз©әж°”пјӣ
еЎ‘е°ҒеҷЁд»¶й•ҝж—¶жҡҙйңІдәҺжҪ®ж№ҝз©әж°”пјҢиЈ…й…ҚеүҚиҰҒзғҳе№Іпјӣ
жҺ§еҲ¶е°ҒиЈ…е·ҘиүәпјҢйҒҝе…ҚеЎ‘е°ҒеҷЁд»¶еҲҶеұӮпјӣ
жҺ§еҲ¶з”өи·Ҝжқҝз„ҠжҺҘе·ҘиүәпјҢйҳІжӯўеЎ‘е°ҒеҷЁд»¶й•ҝж—¶й—ҙиҝҮзғӯгҖӮ
еҚҠеҜјдҪ“еҷЁд»¶зҡ„й“қз”өжһҒдёҺз®Ўи„ҡз”ЁеҶ…еј•зәҝиҝһжҺҘпјҢеҶ…еј•зәҝеҸҜеҲҶдёәйҮ‘зәҝе’Ңй“қзәҝдёӨз§ҚгҖӮйҮ‘пјҚй“қй”®еҗҲеӨұж•Ҳдё»иҰҒиЎЁзҺ°жҳҜпјҡйҮ‘еҶ…еј•зәҝдёҺиҠҜзүҮдёҠзҡ„й“қеұӮеҺӢз„ҠзӮ№еҸ‘з”ҹеӣәзӣёеҸҚеә”пјҢеҪўжҲҗз§°дёәзҙ«ж–‘зҡ„AuAl2еҢ–еҗҲзү©еұӮпјҢеҜјиҮҙжҺҘи§ҰдёҚиүҜжҲ–еј•зәҝи„ұиҗҪгҖӮ
з”ұдәҺйҮ‘вҖ”й“қеҺҹеӯҗдә’жү©ж•Јзҡ„жү©ж•Јзі»ж•°дёҚеҗҢпјҢеңЁйҮ‘пјҚй“қз•ҢйқўиҝҳдјҡеҪўжҲҗ科иӮҜеҫ·е°”пјҲKirkendalпјүз©әжҙһпјҢдјҡеј•иө·еҺӢз„ҠзӮ№ејҖи·ҜгҖӮ
еј•зәҝй”®еҗҲеӨұж•Ҳзҡ„е…¶е®ғеҺҹеӣ жҳҜй”®еҗҲе·ҘиүәдёҚиүҜгҖӮ
еј•зәҝй”®еҗҲеӨұж•Ҳзҡ„еӨ–йғЁеҺҹеӣ е’ҢеҲҶжһҗж–№жі•
еӨұж•ҲеӨ–еӣ пјҡй«ҳжё©иҜ•йӘҢгҖҒжҢҜеҠЁиҜ•йӘҢгҖҒиҝҮз”өеә”еҠӣгҖҒеҸ—жҪ®гҖҒе·ҘиүәдёҚиүҜ
еӨұж•ҲеҶ…еӣ пјҡеҺӢз„ҠзӮ№йҮ‘пјҚй“қеҸ‘з”ҹеҢ–еӯҰеҸҚеә”е’Ңжү©ж•Ј
еӨұж•ҲеҲҶжһҗж–№жі•пјҡXе°„зәҝйҖҸи§ҶгҖҒжү«жҸҸеЈ°еӯҰжҳҫеҫ®й•ңгҖҒжү“ејҖе°ҒиЈ…гҖҒжҳҫеҫ®и§ӮеҜҹгҖҒXе°„зәҝиғҪи°ұеҲҶжһҗ
иҙЁжЈҖж–№жі•пјҡеј•зәҝжӢүеҠӣжөӢиҜ•
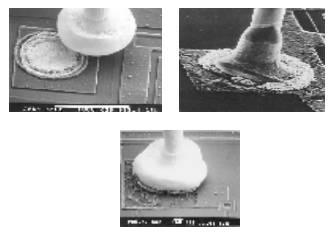
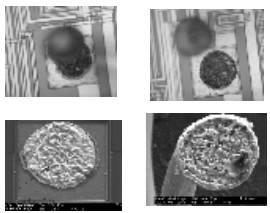
еј•зәҝй”®еҗҲеӨұж•Ҳ
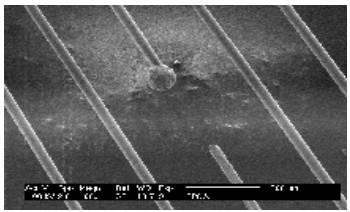
иҝҮз”өзғ§жҜҒеҶ…еј•зәҝ
зә жӯЈжҺӘж–Ҫпјҡ
йҮ‘пјҚй“қй”®еҗҲзҡ„еҷЁд»¶еә”йҒҝе…ҚеңЁиҝҮй«ҳжё©еәҰдёӢдҪҝз”Ёе’ҢиҜ•йӘҢгҖӮдёәйҒҝе…ҚйҮ‘пјҚй“қй”®еҗҲеӨұж•ҲпјҢеҸҜж”№з”Ёй“қзЎ…пјҚй“қй”®еҗҲе’Ңж— зәҝй”®еҗҲгҖӮж°ҙжұҪзҰ»еӯҗжІҫжұЎзҡ„еӨұж•ҲеҲҶжһҗж–№жі•иҠҜзүҮиЎЁйқўж°ҙжұҪе’ҢзҰ»еӯҗжІҫжұЎ
иҠҜзүҮиЎЁйқўж°ҙжұҪе’ҢзҰ»еӯҗжІҫжұЎзҡ„еӨұж•ҲеҲҶжһҗж–№жі•пјҡзғҳзғӨжҲ–ејҖе°Ғжё…жҙ—гҖӮ
иҜ•йӘҢз»“жһңеҲҶжһҗпјҡеҸҚеҗ‘зү№жҖ§еҸҜе®Ңе…ЁжҒўеӨҚдёәзҰ»еӯҗжІҫжұЎе’ҢеҸ—жҪ®еҸҚеҗ‘зү№жҖ§дёҚеҸҜе®Ңе…ЁжҒўеӨҚдёәиҝҮз”өжҲ–йқҷз”өгҖӮ
д»ӢиҙЁеұӮеҶ…йғЁзҰ»еӯҗжІҫжұЎ
вҖўй«ҳжё©еӮЁеӯҳвҖўй«ҳжё©еҸҚеҒҸ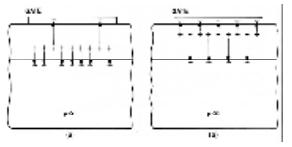
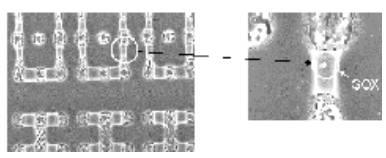
д»ӢиҙЁеӨұж•Ҳ
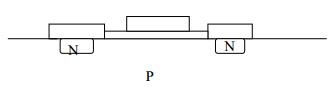
д»ӢиҙЁеӨұж•ҲжңәзҗҶ
EOSжҚҹдјӨзҡ„з§Қзұ»е’ҢжңәзҗҶ
иҝҮжөҒ(еј•иө·иҝҮзғӯпјү
еҶ…еј•зәҝзҶ”ж–ӯ
йҮ‘еұһеҢ–дә’иҝһзәҝзҶ”ж–ӯ
Pnз»“жјҸз”ө
Pnз»“з©ҝй’ү
йҮ‘еұһзғӯз”өиҝҒ移иҝҮеҺӢ:
ж°§еҢ–еұӮй’Ҳеӯ”
зғӯз”өеӯҗжіЁе…Ҙ
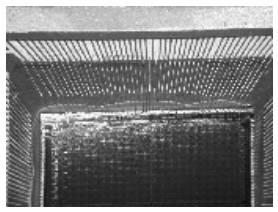
FPGAз”өжәҗеҶ…еј•зәҝзғ§ж–ӯ
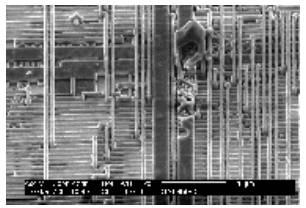
еҫ®еӨ„зҗҶеҷЁз”өжәҗйҮ‘еұһдә’иҝһзәҝзғ§ж–ӯ

дёүз«ҜзЁіеҺӢеҷЁиҝҮз”өзғ§жҜҒпјҢйҮ‘еұһзғӯз”өиҝҒ移
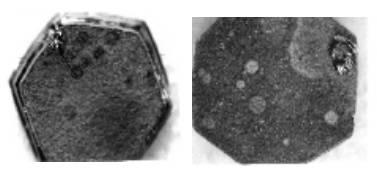
зЎ…ж•ҙжөҒеҷЁRB-156иҝҮз”өзғ§жҜҒ
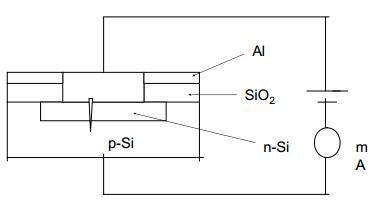
Al-Siдә’жә¶

иөөе·Ҙ
13488683602
zhaojh@kw.beijing.gov.cn
ж¬ўиҝҺеҗ„е…¬дј—еҸ·пјҢеӘ’дҪ“иҪ¬иҪҪпјҢз”іиҜ·еҠ зҷҪеҗҚеҚ•з§’йҖҡиҝҮ
жҠ•зЁҝ/жҺЁе№ҝ/еҗҲдҪң/е…ҘзҫӨ/иөһеҠ©/иҪ¬еҸ‘ иҜ·еҠ еҫ®дҝЎ13488683602
