解决办法
在某些切割应用中,需要高精度地控制切割深度(=叶片高度)。
这种叶片高度控制功能可以实现通过增加一个高度传感器到切割锯。
这一功能在晶片切割和封装中的两个有代表性的例子如下。
DBG工艺--平板硅片的测量与切割深度控制
可润湿侧面-qfn-测量大翘曲工件,如IC封装和切割深度跟踪控制
DBG工艺中的高度控制
在DBG工艺中,采用半切割切割的方法产生沟槽,并通过反磨削对晶片进行细化和切分。
为了获得高质量的模具分离在Z2轴磨削(精磨)过程中,控制半切割切割的深度是非常重要的。

DBG(磨前切块)工艺
可润湿面QFN的高度控制
在传统的QFN封装(四平无铅封装)中,由于封装底部形成了焊点,当晶片被粘合时,很难进行AOI(Automated光学检测)。然而,在可润湿的侧面QFN中,在侧壁上形成了焊料圆角,使外观检查更加容易。因此,可润湿侧翼量子阱已被广泛应用于要求高可靠性的应用,如汽车应用。
在WF-QFN中,通过半切割加工在端子上形成吸收焊料的小孔.通过控制口袋的深度,焊锡片的高度是均匀的,这使得外观检查更加容易。
为了响应大量生产和处理工件翘曲等要求,可以选择各种方法进行半切割加工,例如用于工件安全的方法(磁带/夹具)、高度测量和叶片高度跟踪控制方法。
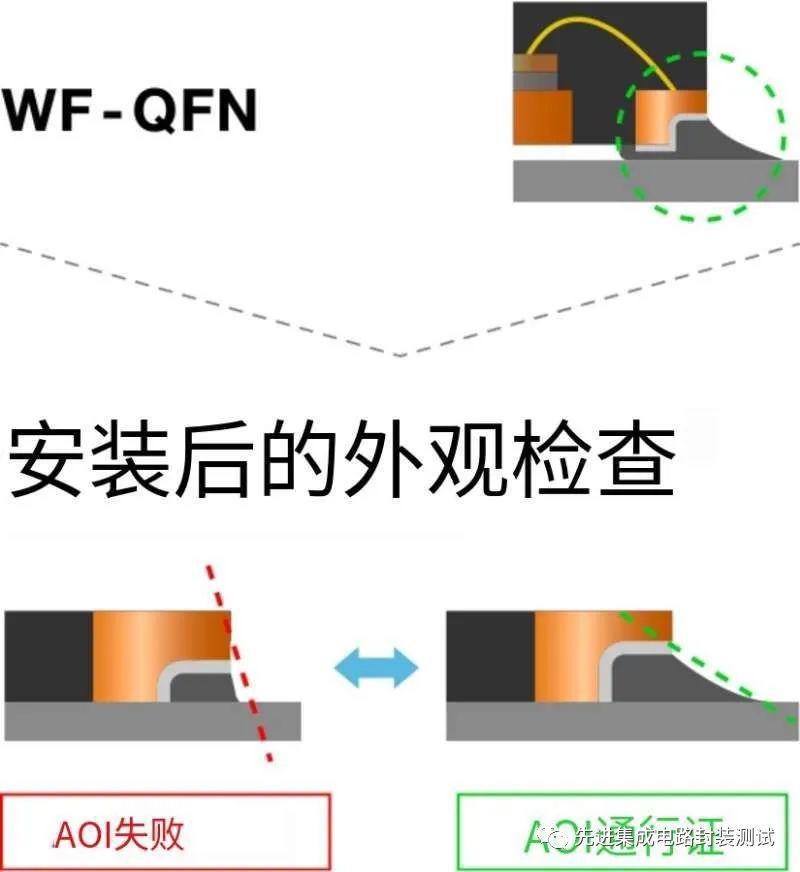

来源:半导体封装工程师之家
