自20世纪90年代以来,原子探针断层成像(APT)技术在显微技术中已经达到了公认的地位。APT能够绘制出不同元素原子的三维空间分布,此外,凭借化学敏感性以及接近原子尺度的空间分辨率,提供了关于纳米结构的独特信息,是属于极少数能够在原子尺度上研究物质的表征技术。
这也解释了为什么这种仪器进入越来越多的研究领域。APT最初专门用于冶金,如今在微电子和纳米电子学中有大量的应用,现在也应用于生物学、软物质和地球科学等其他领域。
1 APT在材料科学中的作用
在原子尺度上对材料进行三维成像不仅是一个梦想,也是一个挑战。这对处理相变或溶质原子偏析到晶格缺陷的基础研究至关重要。
终极尺度的微观结构表征对于具有关键工业材料来说,也是非常重要的,因为它能够更好地控制微观结构的产生和发展,优化加工路线和性能。材料的功能和机械性能不仅取决于微米尺度的特征,如晶粒大小、沉淀物,也取决于纳米尺度的特征,如溶质原子团簇、化学梯度、纳米沉淀物和结构缺陷上的偏析。
FE-SEM具有<1nm的分辨率,但是基于X射线发射的分析能力仍然有限,主要原因是电子在物质中的散射,导致信号的扩展范围约1um(>5KV)。在样品厚度通常<100 nm的TEM或STEM中,这种限制很容易克服。
TEM的空间分辨率限制主要来自像差。在过去的10多年中,球差校正器应用将TEM的常规分析能力达到了原子尺度。然而,在常规实验中,基于EELS或EDS的分析型TEM,化学敏感性通常被限制在约一个原子百分比的范围内。
此外,TEM的二维投影的数据和图像,部分3D信息会丢失。TEM的电子层析成像技术可以获得3D图像和结构信息,但几乎没有接近原子尺度的分辨率。二次离子质谱SIMS克服了TEM技术化学灵敏度的不足,但代价是空间分辨率通限制在约50nm。
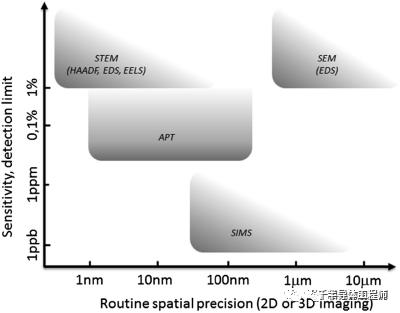
在显微镜分析领域,APT展示了独特的能力:结合了3D信息、近原子分辨率(深度0.1nm,横向< 1nm)和超高化学灵敏度,在最好的情况下,原子的化学灵敏度低至百万分之几。典型的分析体积为50x50x200nm。
但与TEM相比,APT缺少多功能化。首先,这是一种破坏性的技术,不能在同一样品上重复测量,也很难将化学信息与结构联系起来。此外,感兴趣区域的视野更加有限。但APT在近原子尺度上研究材料三维结构的独特能力,包括半导体和氧化物,已经在学术界和工业界形成了不断增长的趋势。
2 APT的早期发展
场离子显微镜(FIM),由E.W.Muller在20世纪50年代初发明、可被看作是现代APT的先驱,两者都是基于高电场。由于FIM具有原子级的分辨率,它在表面科学和物理冶金方面做出了重大贡献。早已经被用于晶体缺陷成像,如晶界(GBs)或空位。相位对比也使其可以定性地研究沉淀、空隙、辐照缺陷、偏析、表面扩散或金属合金中的反应。

左图:PtAu合金表面的FIM图像。每个点都是单个原子的图像。晶体原子平面与样品半球形表面的相交产生了特定的环对比度。右图:通过APT分析钢中的3D结构,显示碳偏析至晶界(两个)和纳米级碳化物[Fe-绿色;C-红色;视野:45×45×120nm].
20世纪70年代,原子探针的早期应用主要限于导体,例如金属合金、金属玻璃、钢材、镍基超级合金以及铝合金,都是第一批被研究的材料。也是第一次有可能揭示纳米尺度的成分波动,并对沉淀的早期阶段有所了解。
20世纪80年代末和90年代初,在仪器上配置了位置敏感探测器,实现了技术上的突破,这一创新赋予了该仪器新的内涵。由E.W. Mulle的一维(1D)原子探针,仅给出1D成分剖面,变成了三维原子探针,可以对纳米级成分波动进行3D成像,并揭示纳米级簇或缺陷(如溶质偏析)的形状、分布和形态。21世纪初,APT技术开始在材料科学实验室广泛推广,成为TEM的补充工具。
第二个重要的突破是用超快的激光脉冲取代电脉冲。这为APT开辟了测量导电性差的材料领域,如半导体、功能材料、氧化物、陶瓷,甚至一些聚合物以及生物材料。这种创新使APT成为纳米科学和微电子学的一种独特技术(纳米线、用于自旋电子的磁性多层,包括含有高电阻氧化层的隧道结)。这一演变是由于FIB技术的平行发展而实现的。
3 APT与TEM、FIB技术的结合
在样品制备阶段,APT通常与SEM-FIB技术结合使用,主要优势之一是SEM-FIB的成像与加工能力,可用于特定感兴趣区域的样品制备。例如,可以使用电子背散射衍射EBSD来选择特定的晶界GBs,并将偏析(将由APT揭示)与取向相关联。
在过去的10年中,已提出TEM与APT结合来表征材料,这有两个截然不同的优势:
(1)使用TEM成像能力来理解或校正APT 3D体积重建伪影(如果有的话);(2)使用TEM可以获得晶体结构、缺陷和取向关系的精确图像,并且易于获得片状缺陷周围溶质元素的空间分布的三维信息(可以考虑两种选择);(3)在分析之前,可以在TEM中观察APT样品,以便识别和表征缺陷,但这需要特殊的样品支架,并且厚度不均匀的针状样品不适合用于分析TEM。因此,在分析扩展特征(如晶界GBs)的情况下,最简单和最佳的程序可能是用FIB在靠近的位置沿感兴趣区域准备一个APT样品和一个TEM样品。对于密度较高的物体,如纳米级沉淀物,可随机制备的TEM和APT样品进行分析,并在统计的基础上进行比较。
参考资料
1.Mueller EW. The fifield ion microscope. Zeit F Phys 1951;131:136e42.
2. Muller EW, Panitz J, Mc Lane SB. The atom probe fifield ion microscope. Rev Sci Instrum 1968;39:83e8.
3.DOI:10.1063/1.2709758
来源于老千和他的朋友们,作者

赵工
13488683602
zhaojh@kw.beijing.gov.cn
欢迎各公众号,媒体转载,申请加白名单秒通过
投稿/推广/合作/入群/赞助/转发 请加微信13488683602
