Q1
иҜ·ж•ҷеӨ§е®¶е…ідәҺLUе®һйӘҢпјҢQ part class2 зӣ®еүҚзңӢеҲ°еҫҲеӨҡжҠҘе‘ҠйғҪжҳҜ3eaй«ҳжё©пјҢ3eaеёёжё©иҝӣиЎҢзҡ„пјҢиҝҷдёӘдёҡз•Ңжңүе•ҘиҜҙжі•еҳӣпјҹ
A1
й«ҳжё©жғ…еҶөжңҖжҒ¶еҠЈпјҢеҸӘйңҖеҒҡй«ҳжё©е°ұеҘҪдәҶпјҢ3йў—з”өеҺӢжҝҖеҠұпјҢ3йў—з”өжөҒжҝҖеҠұпјӣз”өеҺӢжҝҖеҠұз”өжөҒжҝҖеҠұжҳҜдјҡеңЁеҗҢдёҖйў—дёҠжү“зҡ„гҖӮ
Q2
иҜ·ж•ҷдёҖдёӢпјҢWLCSP 2P2Mзҡ„еҰӮжһңPI1е’ҢPI2д№Ӣй—ҙжҖҖз–‘жңүеҲҶеұӮпјҢSATиғҪжү«еҮәжқҘеҗ—пјҹ
A2
зҗҶи®әдёҠеә”иҜҘжІЎй—®йўҳпјҢеҸҜд»Ҙе…Ҳз”ЁTmodeиҜ•дёҖдёӢгҖӮеҰӮжһңдёҚжҳҜйқўз§ҜеӨӘе°ҸжҲ–delamеӨӘиҪ»еҫ®пјҲжҜ”еҰӮZж–№еҗ‘дёҠdelamз”ҡиҮіе°ҸдәҺ0.1umпјүе°ұеә”иҜҘеҸҜд»ҘгҖӮй—®йўҳжҳҜеҰӮжһңжҖҖз–‘жңүй—®йўҳпјҢйӮЈд№Ҳж— и®әSATжҳҜеҗҰжү«еҮәжқҘйғҪйңҖиҰҒеҒҡxsectionйӘҢиҜҒпјҢиҝҷдёӘеҸҜиғҪдјҡжңүйҡҫеәҰгҖӮ
Q3
иҜ·ж•ҷдёҖдёӢпјҢеҜ№дәҺеҚ•йў—зҡ„ICеҷЁд»¶еңЁеҒҡеҸҜйқ жҖ§зҡ„ж—¶еҖҷдјҡеҒҡPCTпјҢиҖҢamkorе’ҢSPILзҡ„йӮЈиҫ№зҡ„е®ҳзҪ‘дёҠзңӢпјҢ他们дёҚеҒҡPCTзҡ„пјҢеҒҡUHASTгҖӮиҝҷеҲҶеҲ«жңүд»Җд№ҲиҖғйҮҸпјҢ PCTзӣёеҜ№UHASTжҳҜдёҚжҳҜеҜ№wlcspдә§е“Ғзҡ„з ҙеқҸжҖ§иҰҒжҜ”UHASTиҰҒејәпјҹ
A3
PCT жҳҜ100%ж№ҝеәҰпјҢеңЁж—Ҙеёёз”ҹжҙ»дёӯдёҚеёёи§ҒпјҢдё”еә”еҠӣжҜ”uHASTејәпјҢжүҖд»ҘзҺ°еңЁеҫҲеӨҡе…¬еҸёйғҪдёҚйҮҮз”ЁPCTиҪ¬иҖҢз”ЁuHASTгҖӮ
Q4
иҝҷдёӘжҳҜз»Ҳз«Ҝе®ўжҲ·дёҠжқҝеҒҡй«ҳжё©иҖҒеҢ–еҸ‘зҺ°еЎ‘е°ҒдҪ“з ҙдәҶдёӘжҙһпјҢdecapеҗҺиҠҜзүҮжІЎжңүзғ§зӮ№пјҢжңүжІЎжңүе“ӘдҪҚйҒҮеҲ°иҝҮзұ»дјјзҡ„жЎҲдҫӢе•Ҡпјҹ
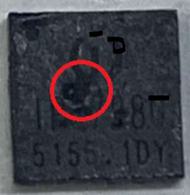
A4
жІЎжңүзғ§зӮ№еҹәжң¬е°ұжҳҜж°ҙжұҪдәҶпјӣеҰӮжһңдёҚжҳҜжү№йҮҸй—®йўҳпјҢеҸҜиғҪжҳҜжү“ејҖеҢ…иЈ…еңЁз©әж°”дёӯж”ҫд№…дәҶзӣҙжҺҘиҝӣй«ҳжё©зғҳз®ұжөӢиҜ•дәҶпјҢеҸҜд»ҘдҪҺжё©зғҳе№ІдёҖдёӢеҶҚжөӢиҜ•гҖӮ
Q5
еЎ‘е°Ғж–ҷдёҖиҲ¬еӣһжё©еҗҺзҡ„жңүж•ҲдҪҝз”ЁжңҹеӨҡд№…пјҹ
A5
еҗ„зұ»еһӢеЎ‘е°Ғж–ҷдёҚдёҖж ·пјҢжңү24е°Ҹж—¶зҡ„пјҢжңүдёүеӨ©зҡ„пјҢе…·дҪ“иҰҒзңӢеЎ‘е°Ғж–ҷдҫӣж–№еҮәе…·зҡ„иҜҙжҳҺд№ҰпјҢдёҖиҲ¬дёҚиғҪи¶…иҝҮдёүеӨ©гҖӮ
Q6
еҰӮжһңдёҚиүҜе“Ғе’Ңеә“еӯҳиүҜе“ҒпјҢйғҪеҒҡдәҶдёҚејҖзӣ–зғӯзӮ№еҲҶжһҗпјҢйғҪеҸ‘зҺ°дәҶзғӯзӮ№гҖӮз»“жһңд№ҹж— жі•дҪңиҜҒжҳҜеҗҰејӮеёёпјҢжҺҘдёӢжқҘиҝҳеҸҜд»Ҙжңүд»Җд№Ҳж–№жЎҲжқҘеү–жһҗжҜ”иҫғеҘҪпјҹйғҪеҮәзҺ°зғӯзӮ№еҸҜд»ҘиЎЁеҫҒд»Җд№Ҳеҗ—пјҹ
A6
йҰ–е…ҲзЎ®и®ӨеҘҪе“ҒжҳҜдёҚжҳҜзңҹзҡ„еҘҪе“ҒпјҢеӣ дёәзғӯзӮ№еҲҶжһҗеҸҚжҳ еңЁдә§е“ҒжҳҜжҹҗдёӘйқўпјҢдә§е“Ғз”ұеҘҪеӨҡжқҗж–ҷз»“жһ„з»„жҲҗпјҢеҗҢдёҖдёӘзӮ№жқҗж–ҷе·®ејӮпјҢејӮеёёеҜјиҮҙйғҪжңүеҸҜиғҪпјҢжҺҘдёӢжқҘйңҖиҰҒеҜ№жҜ”ејҖзӣ–дәҶпјҢеҘҪе“Ғе’ҢејӮеёёе“ҒејҖзӣ–еҗҺдёҚеҗҢз»“жһ„зҡ„е·®ејӮпјҢеҢ…жӢ¬жҖ§иғҪе·®ејӮпјҢиҝҷж—¶еҹәжң¬дјҡз”ЁеҲ°жҺўй’ҲжөӢиҜ•пјҢеҪ“然иҝҳжңүдёҖз§ҚжҜ”иҫғеқҸзҡ„жғ…еҶөпјҢеҘҪе“Ғ并дёҚдёҖе®ҡжҳҜеҘҪзҡ„пјҢиҝҷж—¶еҸҜд»ҘеҒҡworse condition йӘҢиҜҒгҖӮ
Q7
иҜ·й—®InGaAsеҒҡзҡ„зғӯзӮ№зңҹе®һжҖ§дјҡеҸ—еҲ°е“Әдәӣеӣ зҙ еҪұе“Қпјҹдёәд»Җд№ҲеҺ»йҮ‘еұһеұӮжӣҙеҮҶпјҹжҲ–иҖ…жӣҙе®№жҳ“жүҫеҲ°пјҹ
A7
йҮ‘еұһеұӮиҝҮеӨҡпјҢдјҡеҜ№ејӮеёёзӮ№зҡ„дә®зӮ№жңүйҒ®жҢЎпјҢжүҖд»Ҙжңүж—¶дјҡе»әи®®еҒҡиғҢйқўзғӯзӮ№пјӣInGaAsеҪ’ж №з»“еә•е°ұдёӨеҸҘиҜқпјҢдёҖжҳҜMetalеұӮдёҚйҖҸзәўеӨ–пјҢдәҢжҳҜMOSз®Ўе·ҘдҪңеңЁжҲӘжӯўеҢәе°ұдјҡеҸ‘е…үгҖӮ
Q8
ESDеүҚжөӢиҜ•йғҪOK ,жү“е®Ңе°ұжңүз®Ўи„ҡеӨұж•ҲпјҢзҺ°еңЁејҖзӣ–жҳҜcrackзҡ„пјҢиҝҷз§ҚcrackеҸҜиғҪжҳҜESDйҖ жҲҗзҡ„еҗ—пјҢиҝҳжҳҜе…¶е®ғд»Җд№ҲеҺҹеӣ пјҹ

A8
ESDиғҪйҮҸиҫғе°ҸпјҢиғҪеј•иө·еұҖйғЁзһ¬й—ҙй«ҳжё©пјҢдҪҶдёҖиҲ¬дёҚдјҡеҜјиҮҙж•ҙдёӘиҠҜзүҮж–ӯиЈӮпјҢеҰӮжһңеҸӘжңүдёҖйў—еҸ‘з”ҹпјҢжңүеҸҜиғҪжҳҜжң¬иә«еӯҳеңЁmicrocrackгҖӮеҸҜд»ҘеҶҚеӨҡжөӢеҮ йў—иҜ•иҜ•гҖӮиҝҳжңүеҸҜд»Ҙи§ӮеҜҹESD damage-fuseзҡ„зЁӢеәҰпјҢзңӢжҳҜеҗҰи¶ід»Ҙеј•иө·crack. еҰӮжһңеңЁESDжөӢиҜ•д№ӢеҗҺеҸҲиҝӣиЎҢATEжөӢиҜ•пјҢиҝҷдёӘиҝҮзЁӢд№ҹжңүеҸҜиғҪеҠ еү§damageпјҢз”ҡиҮіcrack; иҝҷз§ҚзңӢиө·жқҘеғҸжҳҜеә”еҠӣйҮҠж”ҫжҲ–жңәжў°еә”еҠӣеҜјиҮҙзҡ„crackжҲ–жҳҜpeelingпјҢжҜ”еҰӮеҲ’зүҮеёҰжқҘзҡ„stressгҖӮ
Q9
д»Җд№Ҳдә§е“ҒйңҖиҰҒеҒҡLTOLпјҹ
A9
LTOLпјҡ(Low temperature operation life testпјүпјҡдҪҺжё©еҜҝе‘ҪиҜ•йӘҢпјҢйңҖиҰҒдёҠз”өпјҢеҹәжң¬дёҺHTOLдёҖж ·пјҢеҸӘжҳҜзӮүжё©жҳҜдҪҺжё©пјҢдёҖиҲ¬з”ЁжқҘеҜ»жүҫзғӯиҪҪжөҒеӯҗеј•иө·зҡ„еӨұж•ҲпјҢжҲ–з”ЁжқҘиҜ•йӘҢеӯҳеӮЁеҷЁд»¶жҲ–дәҡеҫ®зұіе°әеҜёзҡ„еҷЁд»¶гҖӮзӣёе…іж ҮеҮҶпјҡJESD22-A108BпјҡTemperature, Bias, and Operating LifeпјӣJESD47KпјҡStress-Test-Driven Qualification of Integrated Circuits
жқҘжәҗпјҡеӯЈдё°з”өеӯҗ

иөөе·Ҙ
13488683602
zhaojh@kw.beijing.gov.cn
ж¬ўиҝҺеҗ„е…¬дј—еҸ·пјҢеӘ’дҪ“иҪ¬иҪҪпјҢз”іиҜ·еҠ зҷҪеҗҚеҚ•з§’йҖҡиҝҮ
жҠ•зЁҝ/жҺЁе№ҝ/еҗҲдҪң/е…ҘзҫӨ/иөһеҠ©/иҪ¬еҸ‘ иҜ·еҠ еҫ®дҝЎ13488683602
