1.引言
当今科学和工程研究的前沿无疑是纳米技术领域:纳米尺度系统的成像、操作、制造和应用。为了保持目前研究和工业进步的势头,继续开发新的纳米技术工具显然是必要的。此外,随着越来越多的工具投入使用,对这些工具的知识和创新应用的需求也越来越高。特别是材料科学的跨学科领域,永远在寻求越来越小规模的成像和分析,以更全面地了解材料的结构-组成-加工-性能关系。此外,通过精确的微纳米加工进行材料制造的能力对于材料科学和其他依赖纳米技术的领域的进步已经成为当务之急。
聚焦离子束(FIB)系统是成功应对这些挑战并有望继续满足未来纳米级需求的一个重要工具。该技术提供了在固体表面任何地方直接进行微纳米级沉积或材料去除的无与伦比的机会;这使得广泛的潜在材料科学和纳米技术应用变得可行。人们对探索这些应用自然产生了极大的兴趣,最近激发了双束FIB系统的发展,通常也被称为DualBeam或CrossBeam,这是一种新的、更强大的工具,与新材料的复杂性同步发展。
聚焦离子束系统将类似于扫描电子显微镜(SEM)的成像能力与精密加工工具相结合。
聚焦离子束系统是由Krohn在1961年进行的用于太空的液态金属离子源(LMIS)研究的成果。液态金属离子源在半导体和材料科学领域发现了新的应用,FIB在20世纪80年代被商业化,成为主要面向日益增长的半导体行业的工具。在半导体制造的发展过程中,人们一直在努力提高光刻技术的效率和速度。光刻胶和掩膜的使用提高了速度和结果的可重复性,但由于所使用的光的波长的基本和实际限制,分辨率没有提高。电子束光刻技术在这方面有明显的改进,因为高能电子的波长要小得多,通常为百分之一到二纳米,而光的波长为数百纳米。然而,电子束(或电子束)光刻技术是一个相对缓慢的过程,而且往往难以穿透较硬的材料,同时因为局部电荷的积累而产生相当大的变形效应。电子虽然容易产生和加速,但根本没有质量来穿透材料并迅速从晶格中移除原子,因此电子束主要停留在成像领域,除了某些非常特殊的环境。因此,对一种具有短波长优势的光刻方法的需求,允许更高的分辨率,但没有电子的低质量带来的缺点,已经在聚焦离子束的使用中找到了答案。
基本上,聚焦离子束系统产生并引导相对大质量元素的高能电离原子流,将它们聚焦到样品上,以达到蚀刻或铣削表面的目的,并作为一种成像方法。离子的质量较大,使它们能够轻易地将表面原子从其位置上驱逐出去,并从表面产生二次电子,使离子束能够在光刻过程之前、期间和之后对样品进行成像。离子束也有许多其他用途,包括从样品上方的气态层中沉积材料。离子束中的离子将原子或分子击落到样品表面,分子间的吸引力将它们固定下来,并将离子植入到表面。
今天的聚焦离子束系统在其柱子的顶部利用一个液态金属离子源来产生离子,通常是Ga+。然后离子被拉出并通过电场聚焦成一束。它们随后穿过光阑,在样品表面上进行扫描。离子-原子碰撞是弹性或非弹性的。弹性碰撞导致表面原子的挖掘,这种技术被称为溅射或铣削,而非弹性碰撞则会导致一些离子的能量转移到表面原子或电子,导致二次电子的发射(那些被激发到足以逃离其外壳的电子)。继二次电子之后,二次离子也会从表面发射出来。
 一个典型的SEM图像显示了双束FIB系统的同时研磨和沉积能力
一个典型的SEM图像显示了双束FIB系统的同时研磨和沉积能力FIB系统有四个基本功能:铣削、沉积、注入和成像。铣削是一个可以挖掘样品表面的过程,因为使用了光束中相对较重的离子。它也可以很容易地转换成一个沉积系统,只需添加一个气体输送装置,允许将某些材料,通常是金属,应用到光束击中的材料表面。当与铣削相结合时,FIB沉积可以创建几乎任何微观结构。离子注入是表面改性的另一个重要组成部分,可以使用FIB。除了这三种材料表面适应性的变化外,FIB系统还具有广泛的成像能力。离子的大尺寸提供了扫描电子显微镜或其他成像工具所不具备的优势。
FIB的独特性能使其能够隔离特定的样品区域,从而只进行必要的修改而不影响整个样品分析的完整性。有了这种技术,FIB可以执行简单的技术,如制作探针孔,以及更复杂的程序,如切割样品的精确三维截面。FIB结合了钻孔和沉积能力,也是故障分析和修复的理想选择。
然而,只使用FIB系统也有一些缺点,包括它经常对样品造成一些不想要的损害。与FIB相关的不足,以及日益复杂的材料,促进了双束聚焦离子束系统的发展:一个在单一显微镜中结合电子束和离子束的系统。尽管FIB系统本身具有广泛的功能和应用,但将FIB的精确成像和加工能力与扫描电子显微镜的高分辨率、无损成像相结合,就会出现以前不可能出现的新的、宝贵的应用。双束FIB擅长对材料层的横截面进行高分辨率的结构、化学和几何分析,这是检查复杂材料及其合成类似物以及分析可能影响许多新材料的性能、耐久性和可靠性的现象的一个必要特征。双光束系统中的SEM和FIB的组合,允许电子束和离子束共生工作,以实现超出任何一个单独系统的限制的任务。
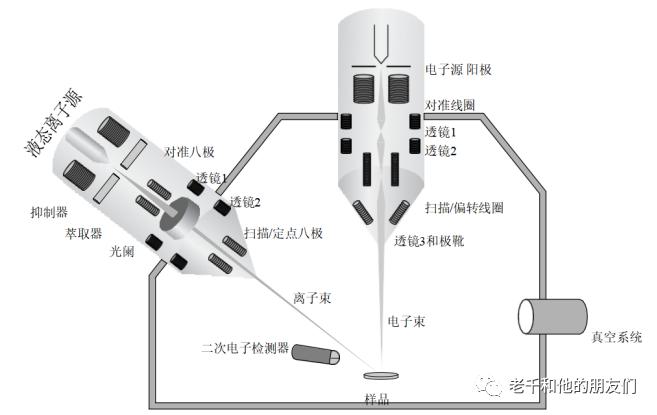
双束聚焦离子束系统配置示意图
离子束和电子束是该系统的两个关键组成部分,解释电子和离子之间的本质区别是很重要的,这样才能理解各自的特性如何影响FIB和SEM的结构和功能。在讨论了离子束和电子束的特性及其发射源之后,我们将看看负责将离子和电子从源头聚焦到显微镜柱中的样品的离子光学和电子光学。还将研究从样品中检测二次和背向散射的带电粒子以形成图像。最后,我们将介绍双光束系统,并讨论其相对于独立的SEM或FIB平台的优势,以及其增强的能力如何为材料科学和纳米技术打开新的渠道。
2. 离子束与电子束
根据仪器的能力,所有的发射都可以成为信息的来源。从聚焦的离子束或电子束射出的信号可以被收集、放大,然后显示出样品表面的详细信息。当离子束长时间集中在一个区域时,连续的溅射过程使机器有了另一个额外的用途,即去除表面材料,这为探测和铣削应用打开了大门。通过在离子束的路径上注入有机金属气体,FIB系统也可以成为一个沉积工具,就在样品表面上方。这种技术允许在微观和纳米尺度上进行多种材料的制造。
由于离子的质量明显高于电子,FIB系统比传统的成像仪器有更多的应用。离子束的大型原生离子与表面原子之间的碰撞会引起不同程度的表面改变,这种改变由剂量、重叠、停留时间和许多其他离子束变量决定。这样的表面改变不可能用电子达到同样的水平。
离子束和电子束是基于相同的原理,并有许多相同的目的。它们都由带电粒子流组成,通过一系列透镜和孔径聚焦到样品上,并且都采用类似的方法来产生和加速来自其源头的粒子。两种系统都可用于对样品进行成像,以及进行蚀刻和沉积。
使用离子束和使用电子束的根本区别在于它们的独特特性。离子比电子大得多,质量也大得多,可以带正电,而电子总是带负电。由于离子的移动速度更慢,需要比电子更大的场来聚焦和控制,因此需要用不同的方法来控制大质量离子和电子。
尺寸和质量可以明显地改变光束和样品之间的相互作用。当一束高能粒子,无论是离子还是电子,撞击到固体表面时,会发生一些相互作用。一些粒子从表面层背向散射;另一些则在固体中被减速。与电子不同,相对较大的离子很难穿透样品的表面,因为它们更难穿过单个原子。相反,它们的大小增加了它们与原子相互作用的概率,导致能量的快速损失。结果是,原子电离的表面原子和打破这些原子之间的化学键--这两个过程主要涉及表面电子--作为主要的离子-原子相互作用发生。二次电子的发射通常伴随着这些过程以及材料的化学状态的变化。然而,与入射电子束的情况不同,内部电子不能被离子束触及或激发,因此不太可能产生特征X射线。

FIB离子和SEM电子的定量比较
离子移动的总长度被称为 "穿透深度",这个术语也适用于电子,它通常比离子更深入地穿透样品。由于原子碰撞的统计学性质,穿透深度总是围绕平均值的对称高斯分布。在材料改性的过程中,移动的离子会使样品中的一个或多个原子反冲,从而导致组成原子的反冲,导致沿着离子束的路径产生原子缺陷。
当然,这两种光束类型之间的另一个区别是,离子束对其目标有更大的直接影响,引起局部加热并移除焦点下方的原子,以及将离子注入表面并将位于样品上方的原子沉积到上面。电子束通常很少或不会造成表面损伤,更难造成沉积,而且一般不会改变样品的内部结构,因为电子束通过后留下的电子会通过传导而消散。
离子的质量比电子大很多倍,因此携带的动量也比电子大数百倍。在离子-原子碰撞中,这种动量被转移到材料表面的原子上,使它们从其排列的位置上受到干扰,这种溅射效应具有重要的铣削应用。离子束,作为离子的大尺寸和大质量的直接结果,超越了电子束的能力范围,能够以精确和可控的方式从材料表面移除原子。
镓(Ga+)离子通常在FIB系统中使用,原因有很多。首先,由于其熔点低,镓只需要有限的加热,并且在操作过程中可以方便地处于液态;较低的操作温度也使其与钨针基质的相互渗透降到最低。第二,它的质量足够重,可以对较重的元素进行磨合,但又不至于重到样品立即被破坏。第三,它在熔点上的低挥发性节省了金属的供应,并产生了约400毫安时/毫克的长源寿命。第四,它的低蒸气压使得Ga可以以纯的形式使用,而不是以合金源的形式使用,后者需要在光学柱中使用E-B质量分离器。最后,镓可以很容易地与其他元素区分开来,所以如果发生注入,镓离子不会干扰样品的分析。尽管可以使用其他离子,但镓已经成为聚焦离子束系统的首选离子。
归根结底,精密工程和FIB设计中对细节的关注的目的是产生一个集中的离子束,在一个理想的点上影响表面。考虑这种冲击的影响是很重要的。入射到表面的一束光会导致局部温度升高、小的电磁波动和光电子发射。一束带电粒子会造成所有这些,甚至更多。入射粒子提高了它们所撞击区域的温度,尽管通常不会达到很高的程度;它们改变了该区域的局部电荷密度,导致暂时的电荷不平衡;它们的动能与样品的能量相加导致二次电子的发射,这可以被捕获并用于样品表面的成像;它们产生一定程度的特征X射线发射,这可以用于光谱学目的;当然,它们对表面结构造成不同程度的损害,这取决于带电粒子的物理性质。
从表面发射的二次电子使这两种光束类型具有成像能力。将光束中的粒子能量与样品中的电子能量叠加,可以使一些电子从材料中逸出(备注:这也一定程度解释了,为什么叠加束的分辨率略低),这取决于光束的穿透深度以及样品的导电性和功函数。这些电子来自于光束点周围和下方的一个大致的球形区域,从地形特征的侧面流出的电子数量增加,否则这些电子不会从平坦的表面逃逸出来。除了二次电子之外,带电粒子的快速减速还产生了一定程度的辐射,一般为X射线光谱。这种辐射后来可用于X射线光谱学。在这种辐射和加速源的辐射之间,试验室需要良好的屏蔽,以保护操作者的安全。所有的现代电子和离子仪器都令人满意地处理了这个问题。
离子束能够有效而精确地沉积材料,通过在样品上方形成一片铂金原子云,让离子束撞击这些原子,给它们带来一些动能,使它们撞击表面,在范德华力的作用下吸附在样品上,就可以沉积铂金。这种技术可用于沉积传导性和电阻性材料,因为注入的气体原子的类型是不同的。

离子束诱导铂金沉积过程的示意图
这使得离子束在纳米制造方面相当有用。这项技术也可用于改善电子束成像,通过在要成像的特征表面沉积一层薄薄的导体。类似于样品的溅射或沉积涂层,这种方法通过使用精确控制的、非常薄的导体层来减少充电效应,在小范围内保留了更多的细节。
在某种程度上,电子束可以用来进行沉积。然而,由于电子的质量很低,沉积发生得很慢,如果电子束非常强烈并精确聚焦,以增加电子与沉积材料的原子相交的概率,则更为可行。一般来说,电子束沉积不是用较小的扫描电子显微镜中的光束来完成的,而是需要一个更大、更强大的仪器。在聚焦离子束出现之前,这种类型的精确沉积是非常难以实现的。
虽然电子束几乎不影响表面,但离子束的重粒子会穿透到晶格深处,一边走一边踢出原子并将其嵌入样品中。因此,在这种情况下,电子束具有平版印刷的光刻能力是非常有用的。它能够在相对较低的束流下,以非常精确和可控的方式从表面去除原子;它能够进行非常小的切割或截取大的截面,所有这些都不会改变样品的化学或结构组成,与传统的蚀刻方法不同,它不需要掩蔽或抗蚀剂阶段。离子束可用于蚀刻和研磨几乎任何材料,很少或没有样品准备。在较高的电流下操作,它能以快速的速度实现非常高的分辨率蚀刻,具有很高的可重复性。此外,该光束可以用来在样品表面注入离子,以调整材料的电子特性。
与电子束不同,使用镓离子束所产生的碰撞会引起许多次级过程,如组成原子的反冲和溅射、缺陷形成、电子激发和发射以及光子发射。由这些碰撞产生的热和辐射诱导的扩散促成了各种组成元素的相互扩散、相变、非晶化、结晶、轨道形成、永久性损伤等现象。此外,离子注入和溅射等过程将改变样品的表面形态,可能会产生坑、面、槽、脊、金字塔、起泡、剥落或海绵状的表面。
由于这些过程的相互关联性,如果不对其他几个过程进行讨论,就无法理解任何一个现象。因此,当务之急是掌握对经验观察的定量理解以及设计的创造性,以便将这些多功能过程的新的和更复杂的组合应用于纳米技术领域。有了它,我们可以瞄准更先进的材料改性、沉积技术、注入、侵蚀、纳米制造、表面分析和许多其他应用。
参考资料:[1] See for an example, M. Nastasi, J. W. Mayer and J. K. Hirvonen. Ion–SolidInteractions: Fundamentals and Applications (Cambridge: Cambridge UniversityPress, 1996).[2] O. B. Firsov. Sov. Phys. JETP, 36 (1959), 1076–80.[3] G. Molie`re. Z. Naturforsch., A, 2 (1947), 133–45.[4] J. Lindhard, V. Nielsen and M. Scharff. Mat. Fys. Medd. Dan Vid. Selsk., 36: 10(1968).[5] J. F. Ziegler, J. P. Biersack and U. Littmark. The Stopping and Range of Ions in Solids (New York: Pergamon Press, 2003).[6] H. Bethe. Ann. de Phys., 5 (1930), 325–400.[7] F. Bloch. Zeit. F. Phys., 81 (1933), 363–76.[8] J. Lindhard, M. Scharff and H. E. Schiott. Mat. Fys. Medd. Dan Vid. Selsk., 33:14 (1963).[9] Phaneuf M W. FIB for materials science applications-A review[J]. Introduction to focused ion beams: Instrumentation, theory, techniques and practice, 2005: 143-172.来源于老千和他的朋友们,作者

赵工
13488683602
zhaojh@kw.beijing.gov.cn
欢迎各公众号,媒体转载,申请加白名单秒通过
投稿/推广/合作/入群/赞助/转发 请加微信13488683602
