归纳起来芯片封装技术的基本工艺流程为:硅片减薄、硅片切割、芯片贴装、芯片互连、成型技术、去飞边毛刺、切筋成型、上焊锡、打码等工序,如下图所示:
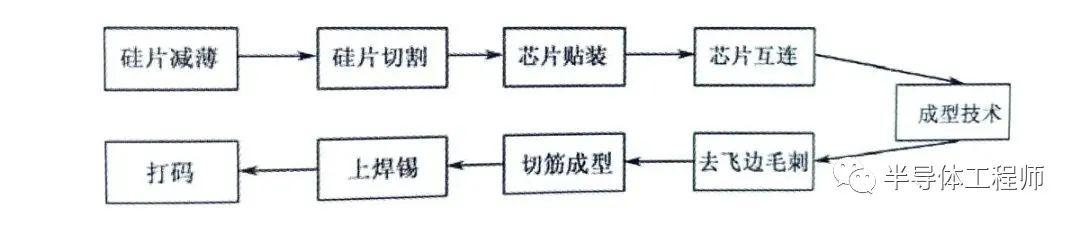
目前大批量生产所用到的主流硅片多为6英寸、8英寸乃至 12 英寸,由于硅片尺寸直径不断增大,为了增加其机械强度,厚度也相应地增加,这就给芯片的切割带来了困难,所以在封装之前一定要对硅片进行减薄处理。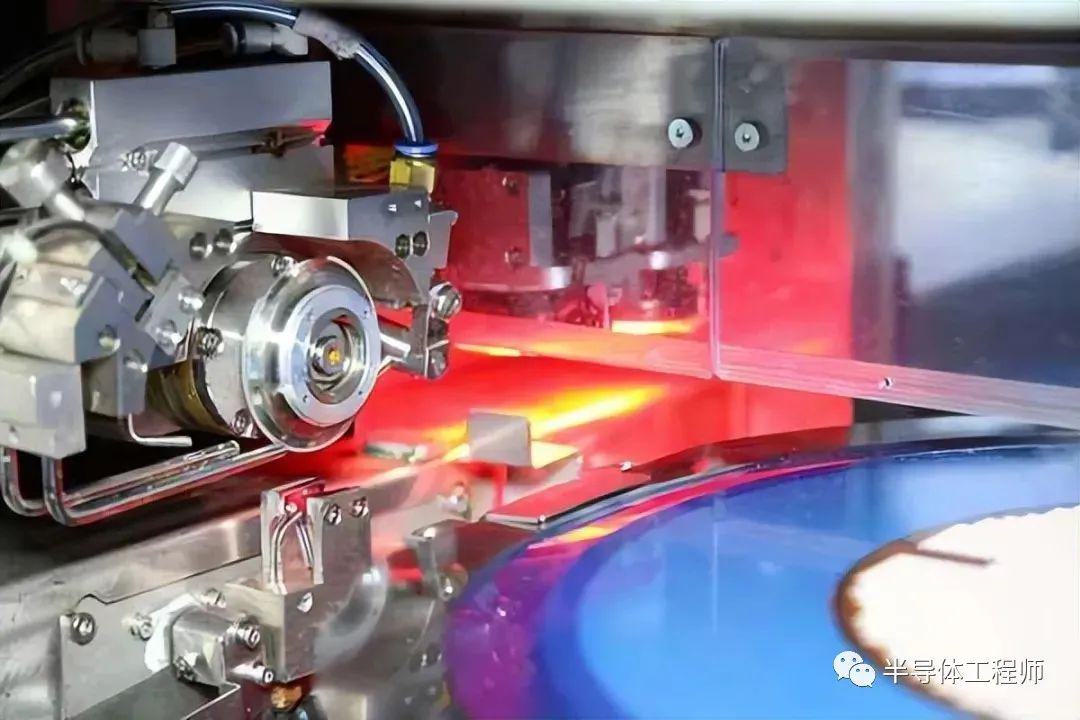
目前,硅片的背面减薄技术主要有磨削、研磨、干式抛光 (Dry Polishing)、化学机械平坦工艺(CMP)、电化学腐蚀 (Electrochemical Etching)、湿法腐蚀 ( Wet Etching)、等离子增强化学腐蚀 (Plasma-Enhanced Chemical Etching, PECE)、常压等离子腐蚀 ( Atmosphere Downstream Plasma Etching, ADPE) 等。
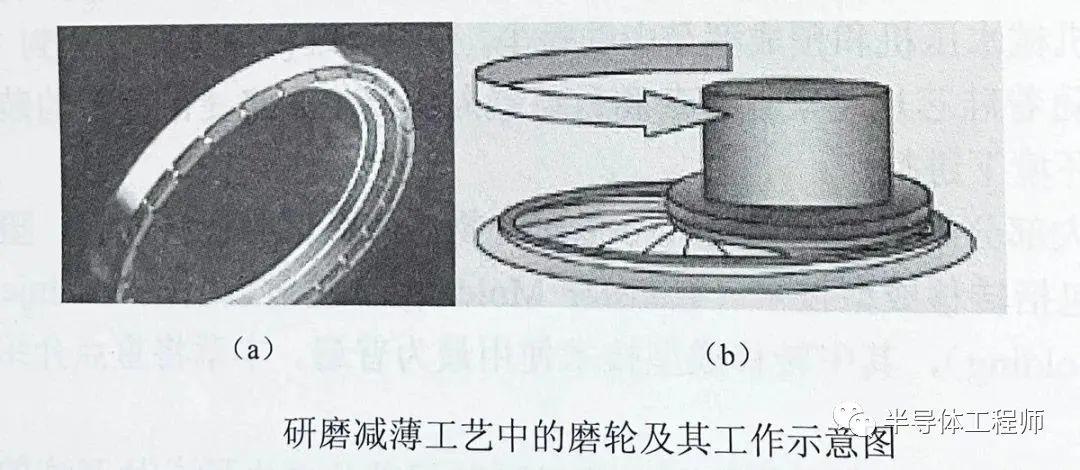
减薄后硅片粘在一个带有金属环或塑料框架的薄膜常称为蓝膜)上,送到芯片切割机进行切割,切割过程中,蓝膜起到了固定芯片位置的作用。切割的方式可以分为刀片切割和激光切割两个大类。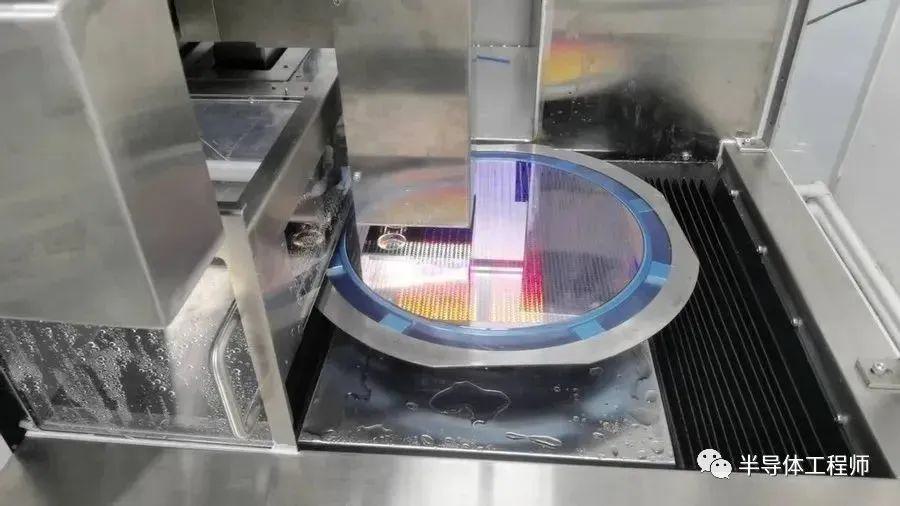
刀片切割是较为传统的切割方式,通过采用金刚石磨轮刀片高速转动来实现切割。由于切割过程中有巨大的应力作用在硅片表面,故在切割位置附近不可避免地会产生一定的崩裂现象。在刀片切割中,切割质量受磨粒因素影响较大。采用细磨粒的刀片进行切割产生的芯片边缘崩裂要显著低于普通磨粒切割的效果,如下所示。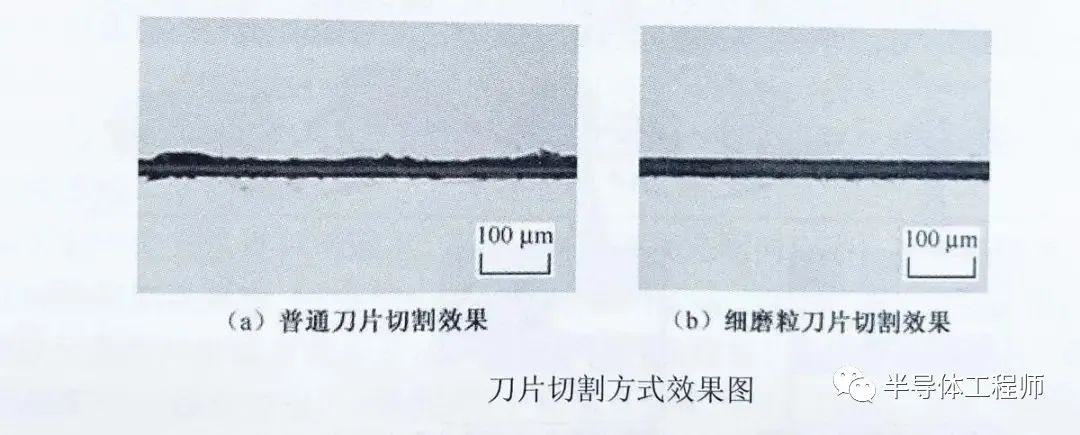
由于现在的晶圆减薄技术越来越先进,所以晶圆能变得越来越薄,和划片机的应力作用的双重作用下,这对精密切割的划片机提出了新的要求。
可喜的是,国内划片机行业的划片设备中的陆芯半导体在划片行业的技术已经实现弯道超车,领跑行业!
陆芯公司拥有精密机械自动化技术、电气自动化技术、计算机应用技术、半导体划片工艺应用技术的研发中心,聚集了一批相关领域资深的高级专业人才和研发专家;公司采用了先进、科学、有效的现代化企业管理模式,成功建成多条完整的半导体划片设备专用产线和一间专业的万级净化间划切实验室。
在产品力方面,目前已成功研制并量产LX6366型双轴精密划片机和LX3352单轴高端精密划片机,兼容6-12英寸材料切割,设备性能均超国际标准。更建立了完善的交货和售后保障,缩短交货周期至3个月,而精度和稳定性是陆芯精密划片机的核心竞争力。


分享二维码到朋友圈免费为您发文章一篇欢迎各公众号,媒体转载
投稿/推广/合作/入群/赞助/转发 请加微信13488683602